4 月 19 日消息,SK 海力士宣布和台积电签署谅解备忘录(MOU),推进 HBM4 研发和下一代封装技术,目标在 2026 年投产 HBM4。

根据双方签署的谅解备忘录,两家公司初期目标是改善 HBM 封装内最底层基础裸片(Base Die)的性能。
IT之家注:HBM 是将多个 DRAM 裸片(Core Die)堆叠在基础裸片上,并通过 TSV 技术进行垂直连接而成,基础裸片也连接至 GPU,在 HBM 中扮演非常重要的角色。
包括 HBM3E(第五代 HBM 产品)在内,SK 海力士旗下 HBM 产品的基础裸片此前均采用自家工艺制造,而从 HMB4(第六代 HBM 产品)开始,该公司将采用台积电的先进逻辑(Logic)工艺。
消息称双方将会展开紧密合作,尝试使用台积电的 CoWoS 技术封装 SK 海力士的 HBM 产品,从而在性能和功效等方面,进一步满足客户的定制化(Customized)HBM 产品需求。
SK 海力士今年 2 月还制定了 One Team 战略,通过台积电建立 AI 半导体同盟,进一步巩固在 HBM 领域的优势。
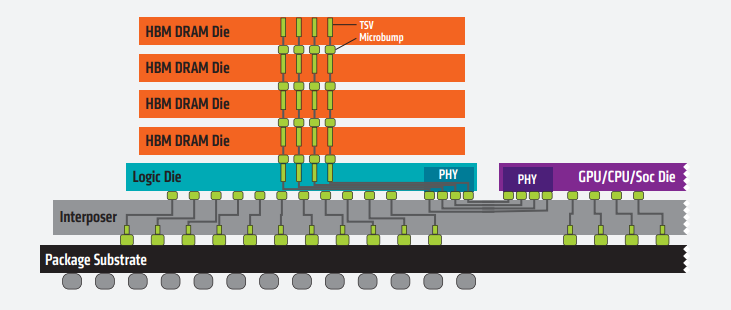
▲ HBM 内存结构示意图,图源 AMD 官网
此外,未来 AI 半导体将从 HBM 时代的 2.5D 封装走向 3D 堆叠逻辑芯片和存储芯片的新型高级封装。存储企业同芯片代工 + 高级封装企业的合作有利于相关研发推进。







